0 引言 随着便携式电子系统复杂性的增加,依靠减小特征尺寸来不断提高集成度的方法已经不能满足当前需要。为了不断提高封装密度并且降低功耗,进一步实现电子产品的多功能化和小型化,在二维平面封装基础上,将裸芯片沿Z轴层叠在一起可以在小型化方面取得极大改进。于是三维封装技术应运而生。 1 3D 封装技术 3D封装就是把IC芯片一片片叠合起来,在Z方向垂直互连,将平面组装向垂直方向发展为立体组装,典型的3D封装结构图如图1所示,其内部切面如图2所示。这种三维技术允许基本电路元器件(比如电阻、电感、电容、二极管和三极管)在垂直方向堆叠,而不仅仅是平面上的互连,它可以使单位面积上具有更高的集成度。3D封装使用的是三维互连技术,所谓三维互连即允许基本电子元器件垂直堆叠。目前广泛使用的三维互连技术有五种:三维封装,三维晶圆级封装,三维片上系统,三维堆叠芯片及三维芯片。3D封装技术的优点很多,在尺寸和重量方面,3D设计替代单芯片封装缩小了器件尺寸并减轻了质量;在硅片效率方面,3D封装更有效的使用了硅片的有效区域;在传输延迟方面,3D封装缩短了互连长度就降低了互连伴随的寄生电容和电感,从而缩短了信号的传输延迟;在功耗方面,3D技术制造的产品由于缩短了互连长度,降低了互连伴随的寄生性,功耗自然会更低;最后,在速度方面,由于3D元器件尺寸和噪声的减小,使得每秒转换率更高,速度就更快。 虽然3D封装和传统二维封装相比有很多优点,但它也并非完美无缺。3D封装技术面临的一个很大的技术难题就是散热处理问题。随着高性能系统建设要求的提高,电子封装的电路密度正在不断提高,而提高电路密度就意味着提高功率密度,功率密度在过去的15年内已呈指数增长,在未来仍会持续增长。采用3D技术制造的元器件功率密度更高,因此,散热处理问题将不得不认真考虑。 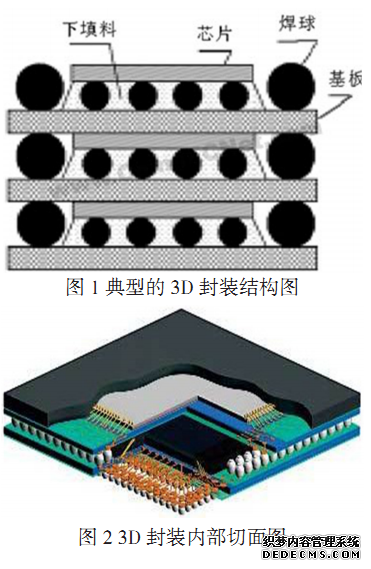 2 散热问题研究 目前,3D技术主要是在两个层次上进行热处理,一个是系统设计级,另一个是封装级。在系统设计级进行散热处理可以将热能均匀的分布在3D元器件的表面。而在封装级进行散热处理,可以有三种办法。其一,采用金刚石或者化学气相沉积金刚石的低热阻基板;其二,采用强制风冷或冷却液来降低3D元器件的温度;其三,采用一种导热胶并在叠层元器件间形成热通孔来将热量从叠层内部排到其表面。随着电路密度的增加,散热处理将会面临更多更复杂的问题。3D封装中的TSV技术实现了芯片之间的面互连,是3D封装的发展方向。很多学者在 TSV 的热传导方面做了很多研究,目前所采用的方法有带温度传感器的微通道热沉法,TSV导热柱方法以及微管液态冷却技术等。为了解决三维封装的散热问题,各大科研机构和生产制造商还相继开发了不同的三维封装低温键合技术,例如自组装单层键合(键合原理是表面改性;其优点是操作简单且成本低廉)、表面活化键合(键合原理是表面处理提供活性;其优点是键合过程不需加热加压,低应力和低损伤)、Ti 作钝化层的 Cu-Cu 键合(键合原理为抗氧化并提高表面活性;其优点是键合前不需表面处理并兼容CMOS工艺)、插入式低温键合(键合原理为提高表面活性;其优点是利用特殊微纳结构增加键和强度)、超声键合(键合原理为利用超声提高表面能;其优点是降低了待键合表面的粗糙度要求)以及纳米热压低温键合(键合原理为纳米尺寸效应或高表面效应;其优点是有效降低了键合温度和压力并兼容现有CMOS工艺)技术等。武晓萌等人针对异构多芯片的三维热管理问题提出了柔板封装的解决方案,柔板封装更有利于降低封装体的结温且温度分布将更加均匀,还可以消除热点。王宁等人提出了三维封装芯片Cu-In体系固液互扩散的低温键合方法,可以在更低温度下实现键合。 3 结语 三维封装技术改善了电子系统的许多方面,如尺寸、质量、速度、产量及耗能。当前,3D封装的散热处理问题虽然有很多学者提出了很多解决方案,但并没有一个公认的完善的解决方案,预计随着封装技术的进步,3D封装的散热问题也会得到进一步解决。 【参考文献】 [1]李可为.集成电路芯片封装技术[M]. 电子工业出版社 ,2014(6). [2]武晓萌.基于柔性基板的异构多芯片三维封装散热仿真与优化设计 [J].科学技术与工程,2014(7):238-241. [3] 王宁 . 三维封装芯片 Cu-In 体系固液互扩散的低温键合机理研究 [J]. 机械制造文摘 ,2013(1):32. |